2026年4月3日,按照第三代半导体产业技术创新战略联盟标准化委员会(CASAS)相关管理办法,经CASAS管理委员会投票通过由天津工业大学牵头提出的《半导体器件封装用烧结铜焊膏》、《宽禁带半导体器件直冷散热用大面积烧结金属互连工艺规范》团体标准立项建议,详细信息如下:
|
序号 |
科目 |
|
|
1 |
T/CASAS 077 半导体器件封装用烧结铜焊膏 T/CASAS 078 宽禁带半导体器件直冷散热用大面积烧结金属互连工艺规范 |
|
|
牵头单位 |
天津工业大学 |
|
|
联合单位 |
广州汉源微电子封装材料有限公司、重庆有研重冶新材料有限公司、江苏宏微科技股份有限公司、中国电子科技集团公司第五十五研究所 |
|
秘书处将向CASAS正式成员发出征集起草单位的通知,组建标准起草小组,请CASAS正式成员关注秘书处邮件(casas@casa-china.cn)。
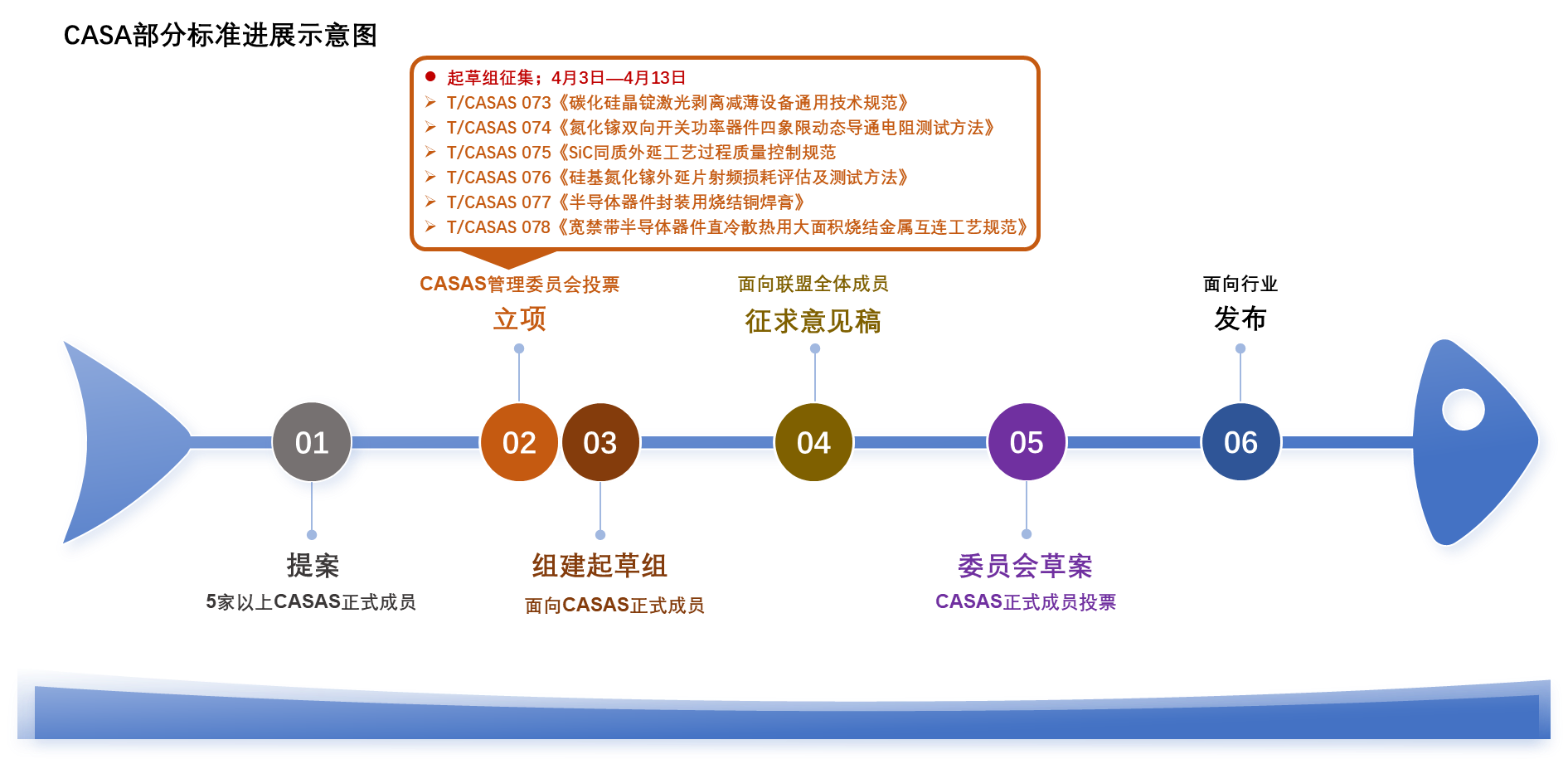
天津工业大学宽禁带半导体器件封装与可靠性研究团队
依托于大功率半导体照明应用系统教育部工程研究中心,团队主要的研究方向有半导体照明系统集成技术、光电显示与检测技术、新型半导体光电材料与器件;大功率电力电子器件等。
团队共有教师10余人,具有丰富海外科研工作经验。团队成员曾获国家优秀青年科学基金、天津市杰出青年科学基金,天津市中青年科技创新领军人才、天津市131高层次人才等称号,获省部级科技奖一等奖4项及教育部青年科技奖。团队一直从事电力电子器件高可靠封装设计、材料与制造科学研究。围绕“如何克服宽禁带器件器件封装失效,实现高可靠器件设计与制造”这一难题及其内在关键科学问题开展研究,成功已为我国宽禁带功率器件的高可靠性、长寿命集成制造与自主可控提供了理论支撑与实践应用。团队已与多家企业合作设计并研制20款模组,部分功率密度超国外同类竞品5倍;研制融合原位三维缺陷重构的多场应力实验装备,解决了封装缺陷无损表征与解耦评定难题,在航天等多家单位应用;发明高耐温可靠纳米银封装互连新材料,填补相关技术空白,牵头制定并发布该材料首个行标,技术已产业化,产品可以替代进口。
目前团队已建立了封装材料制备、表征、可靠性评定技术和器件封测科研平台,通过与华为、蔚来汽车、一汽红旗、广州汉源微、国网南瑞半导体、国防院所等30余家企业合作开发、技术应用或担任特聘专家顾问等,在器件低温界面互连新材料与失效评定、可靠性设计理论与方法、长寿命器件高可靠制造技术等方面取得了一系列创新性研究成果,取得了具有显著经济与社会效益。曾获IEEE CPMT Young Award、电工技术—正泰科技奖、第三代半导体产业技术创新战略联盟(CASA)“特别贡献奖”等。

